英特尔安装业界首款商用高NA EUV光刻机,为14A奠定基础

[洞见热管理]获悉,英特尔宣布已安装ASML的Twinscan EXE:5200B,这是业界首款为商业芯片生产设计的高NA光刻工具,配备0.55口径数值投影光学器件。该工具已通过验收测试,将用于英特尔14A制造工艺的开发,该工艺将成为全球首个依赖高NA极紫外扫描仪处理关键层的节点。这一成就表明高NA极紫外光刻正从早期实验迈向大规模生产(HVM)。
ASML的Twinscan EXE:5200B基于英特尔2023年为俄勒冈研发工厂接收的第一代EXE:5000平台。该新工具能够“打印”8纳米分辨率的芯片,实现了目前低NA极紫外分辨率工具在不使用多图案化的情况下实现的超标化。与EXE:5000不同,EXE:5200B能够在50 mJ/cm²剂量下处理175片晶圆/小时(较20 mJ/cm²剂量时的185片晶圆提升),并实现0.7纳米的覆盖精度,这是随着特征尺寸持续缩小而至关重要的参数。
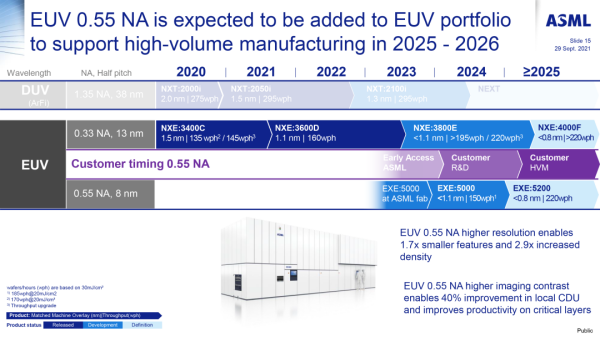
为提升性能,扫描仪集成了高功率极紫外光源,使得在50 mJ/cm²剂量下实现更快的晶圆曝光。这反过来支持了可作的光阻/工艺窗口,具有强烈的图像对比度,同时最大限度地减少线边粗糙度(LER)和线宽粗糙度(LWR),而这些在现代生产节点中往往具有挑战性。
ASML和英特尔的工作并未局限于光学和光源。他们还重构了晶圆储藏系统,该系统负责晶圆的存储、排队和进出扫描仪。对于下一代工具,这一系统组件直接影响生产力和模式化准确性。
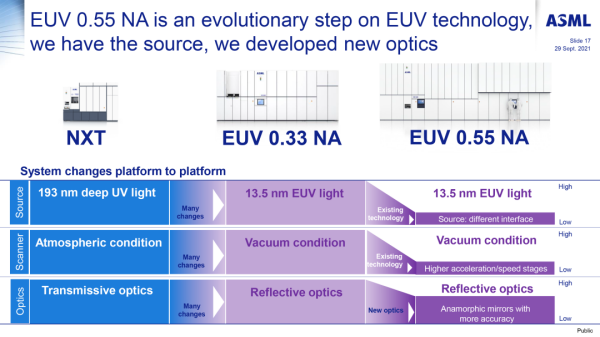
更新后的陈列器设计改善了批次流和晶圆处理,确保晶圆以更可预测的状态进入暴露阶段。同时,它提供了更严格的热控,使晶圆和载体在暴露前后保持稳定温度,这一点非常重要,因为即使是微小的温度变化也可能导致晶圆膨胀或收缩,导致叠加误差,进而增加缺陷和良率下降。
此外,通过减少热和机械变化,新架构有助于在长距离运行中最小化漂移,从而使扫描仪保持稳定行为,减少频繁重新校准的需求。这种稳定性对于多遍和多重曝光图案化尤为重要,未来几年这些技术必将被用于亚1纳米工艺技术。
EXE:5200B的一个难以估量的参数是其0.7纳米的叠加性能,这得益于级控、传感器校准和环境隔离的进步。叠加性能对下一代工艺技术至关重要,因为即使是微小的对准误差也可能导致屈服率损失。

