从 EDA 到 TDA!清华团队重新定义芯片“热设计”
来源 | Journal of Applied Physics
链接 | https://doi.org/10.1063/5.0288828
01
背景介绍
当你在手机上畅快玩游戏、用电脑渲染 4K 视频时,是否想过这些高性能电子设备背后隐藏着一个 “隐形杀手”—— 热量?随着半导体技术不断突破,芯片的功率密度越来越高,特征尺寸却朝着深纳米级迈进,曾经 “够用” 的散热方案,如今正遭遇前所未有的挑战。

现代集成电路(IC)面临的热管理困境,早已不是简单加个散热片就能解决的问题。更高的功率密度与集成度,让芯片局部过热成为常态:轻则导致性能降频、功耗飙升,重则缩短设备寿命,甚至引发硬件故障。无论是高性能计算芯片、射频(RF)器件,还是氮化镓(GaN)、碳化硅(SiC)这类宽禁带功率电子,热管理都已成为制约技术突破的核心瓶颈。
要解决这个难题,首先得搞懂芯片里的 “热量旅程”。在晶体管层面,热量主要来自有源区电子与声子相互作用产生的焦耳热,这些热量在扩散过程中会形成局部热点,而当晶体管尺寸和声子平均自由程(MFP)处于同一量级时,经典的傅里叶热传导定律会彻底失效,非傅里叶热输运现象会让热点温度进一步升高。
更复杂的是,热量从单个晶体管传递到整个芯片的过程中,还要跨越多层外延结构带来的材料界面,这些界面产生的热边界电阻(TBR)会严重阻碍散热。之后,热量需通过一级热界面材料(TIM1)传递到芯片盖,再经二级热界面材料(TIM2)导入外部冷却系统,最终散发到环境中 —— 任何一个环节 “卡壳”,都会导致热量堆积。
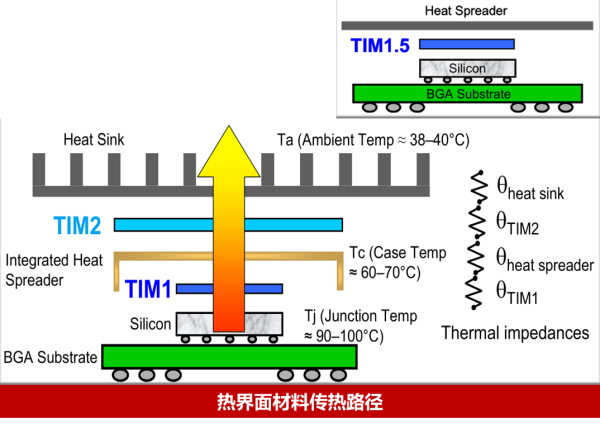
而先进封装技术的出现,让热管理难度再上一个台阶。2.5D 集成通过中介层连接多个芯粒,不同工况下的功率分布差异显著;3D 集成采用硅通孔(TSV)垂直堆叠芯片,热量垂直传导路径更复杂;背面功率传输网络(BSPDN)则迫使热量通过后端互连(BEOL)层,相比传统正面供电,热输运场景更为棘手。
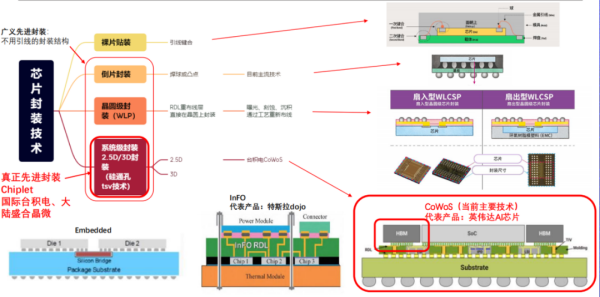
长期以来,芯片设计主要依赖电子设计自动化(EDA)工具聚焦电学性能,热设计往往等到电学设计和封装完成后,才通过外部冷却方案 “亡羊补牢”。但如今,芯片内部热阻已占据总热预算的很大比例,单纯靠外部散热根本无法满足需求。要打破这一困境,就需要一套从设计源头融入热管理思维的全新框架。
02
成果掠影

近日,针对芯片功率密度攀升纳米级热效应失效的困境,清华大学曹炳阳教授提出热设计自动化(TDA)框架,以 “从原子到系统” 的全尺度协同设计,为行业痛点提供解决方案,核心成果可概括为三点:
(1)全尺度仿真打通从微观到宏观的热分析闭环;TDA 最核心的突破是打破尺度壁垒,构建连贯的热仿真体系:
原子级精准建模:靠第一性原理计算 + 机器学习势函数(MLP),获取电子 - 声子耦合等基础属性,为后续仿真筑牢物理基础;
纳米级捕捉非傅里叶效应:用声子蒙特卡洛(MC)方法求解玻尔兹曼方程,精准模拟晶体管内非傅里叶热扩散与自热效应,比如定位 GaN 器件漏极侧热点迁移;
中宏观高效衔接:通过有限元法(FEM)和紧凑热模型(CTM),将纳米级仿真参数无缝对接至电路 / 芯片级分析。例如自研的 H3Therm 模块,4.27 秒就能完成 3D-IC 温度模拟,比传统方法(约 12 分钟)快超 160 倍;
(2)设计逻辑重构:从 “被动散热” 到 “主动控热”,区别于传统 “先电学、后散热” 的思路,TDA 把热管理嵌入设计全流程:
源头减热:通过结构设计降低热源强度。比如 GaN HEMT 用 6° 倾斜场板,能让峰值电场与热生成密度降 50%,芯片最高温度降 16.3%;
优化热路径:选高导热衬底(如金刚石衬底使 GaN 功率密度达 56W/mm,超硅衬底 12 倍),并改进热界面材料(TIM),用液 - 固金属共掺杂技术把界面热阻降一个量级;
加速设计周期:华为应用后,热管理结构设计周期缩 70%,GaN 功率放大器效率提 1%、热阻降 20%。
传统 EDA 只在封装阶段考虑散热,TDA 则把热分析提前到材料选择、器件设计阶段。兼顾效率与精度,既保原子级仿真准确性又靠 CTM、FEM 平衡计算效率。像服务器散热中,TDA 驱动的 “飞鱼” 散热器 + 双循环相变浸没冷却,散热能力翻倍,系统 PUE 低至 1.04;同时预留 AI 与高性能计算接口,计划扩展电热材料数据库,推动与主流 EDA 无缝集成,支撑亚 2nm、超宽禁带器件等下一代技术。
简言之TDA 的价值不仅是解决现有热难题,更在于重新定义 “热” 在芯片设计中的角色 —— 从后端补救的 “附属问题”,变成贯穿全程的 “核心变量”,为半导体突破热瓶颈提供了可落地的路径。研究成果“Thermal design automation (TDA) for multiscale thermal management of electronic”为题发表在《Journal of Applied Physics》。
03
图文导读

图 1:热设计自动化(TDA)框架示意图,展示其如何系统整合半导体设计各层级的热仿真与管理方法,覆盖从原子尺度到系统级的热现象。
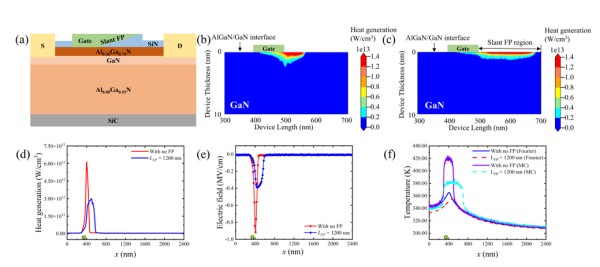
图 2:倾斜场板(FP)优化氮化镓高电子迁移率晶体管(GaN HEMT)热生成的相关仿真结果。(a)传统 AlGaN/GaN HEMT 中带 6° 倾斜角、长度 1200nm 的栅极连接场板结构;(b)(c)偏置条件为 VGS=1V、VDS=8V 时的热生成分布对比(传统设计 vs 倾斜场板设计);(d)(e)异质结界面下沟道的热生成与电场强度横向分布;(f)基于傅里叶热传导定律与声子玻尔兹曼输运方程(BTE)的器件沟道下方温度分布对比。
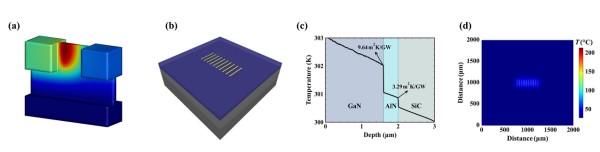
图 3:热设计自动化(TDA)模块在多尺度热仿真中的应用案例。(a)鳍式场效应晶体管(FinFET)结构的电热协同仿真结果;(b)多指状 GaN HEMT 的结构示意图;(c)GaN 异质结构中的温度分布曲线及对应等效热物性参数;(d)GaN HEMT 热源平面温度场分布的多尺度热分析预测。

图 4:热边界导纳(TBC)计算示意图。(a)碳化硅 / 氮化铝(SiC/AlN)与氮化铝 / 氮化镓(AlN/GaN)异质结构的原子结构;(b)GaN、AlN 与 SiC 的群速度;(c)基于晶格动力学(LD)方法的 SiC/AlN 与 AlN/GaN 界面频率相关透射率;(d)GaN、AlN 与 SiC 的声子态密度;(e)SiC/AlN 与 AlN/GaN 界面的光谱热边界导纳;(f)SiC/AlN 与 AlN/GaN 界面的热边界导纳随温度变化曲线。
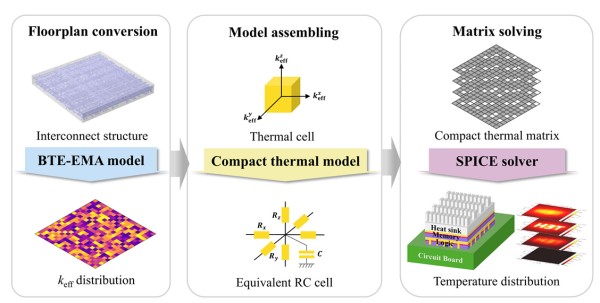
图5:紧凑热模型(CTM)工作流程及三维集成电路(3D-IC)的热感知设计示意图,展示如何通过自适应功率感知细化策略优化模型粒度,实现高效准确的热仿真。
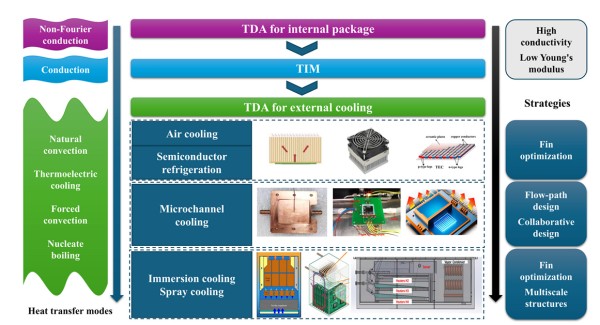
图6:芯片外部冷却技术的热设计自动化(TDA)应用示意图,涵盖空气冷却、微通道冷却、浸没式冷却等主流冷却方案的 TDA 整合逻辑。
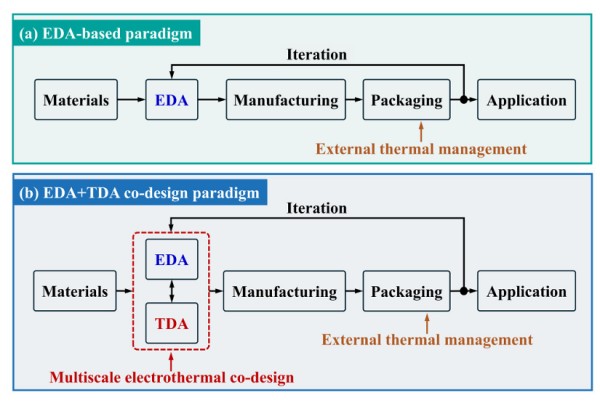
图7:热感知电子设计中研发范式对比图。(a)传统基于电子设计自动化(EDA)的范式:聚焦封装阶段的外部热管理;(b)提出的 EDA+TDA 协同设计范式:将多尺度内部电热协同设计融入早期设计阶段,实现 EDA 与制造流程间的迭代优化以提升热性能。
值得一提的是,本次研究的主要作者——清华大学曹炳阳教授也将作为第六届热管理产业大会暨博览会大会顾问和报告嘉宾出席分享《集成电路热管理材料研究》的大会报告。

曹教授带领的HEG课题组主要集中在:(1)纳米结构中的热传递,包括半导体、聚合物、金属等非晶态或异质纳米材料中的非傅里叶传递效应和热物理性质;(2)热功能材料,如具有高导热系数的热界面材料、具有可调热性能的智能材料、纳米电学或能源中的异质结构纳米材料;(3)热管理技术,即集成电路、能源、激光、航天器等领域的仿真、测量、设计和器件。

大会时间:2025年12月3–5日
大会地点:深圳国际会展中心宝安(10号馆)

