电子热管理新方案!嵌入式微通道+TEC制冷模块
来源 | Applied Thermal Engineering
链接 | https://doi.org/10.1016/j.applthermaleng.2025.128568
01
背景介绍
热电冷却器(TEC)作为固态冷却技术,具有无运动部件、集成灵活的特点,是现代电子热管理的重要方案。传统 TEC 集成系统依赖热界面材料(TIM) 连接芯片与 TEC 冷端、TEC 热端与散热结构,TIM 引入的寄生热阻会增大 TEC 冷热端温差,导致 TEC 效率(COP)和冷却能力下降;同时,高功率密度芯片下,TEC 热端积热会加速材料老化、引发层间剥离,进一步降低可靠性。现有研究(如空气冷却、液冷、微流道冷却)多聚焦单端热阻优化(如仅优化热端散热),未同时解决冷热端 TIM 带来的寄生热阻问题,无法全面释放 TEC 性能。
02
成果掠影

近日,中国科学院大学朱航天联合西安交通大学张国和、焦斌斌团队,提出双嵌入式冷却模块(DECM):将热电制冷片直接集成在芯片背面(芯片作为 TEC 冷端),并在热端基板嵌入微流道(冷却液体直接流动);通过含温度传感器和加热功能的硅测试芯片评估,相比传统 TEC-MC 冷却模块(TMCM),DECM 实现制冷系数(COP)提升 33%、等效冷却条件下总热阻降低 61%、TEC 外额外热阻占比减少 47%,在等效热边界条件下冷却功率提升 66%(最大 44.5W)、温差提升 27.2%,同时消除 TIM 并规避 TEC 与硅芯片的异质集成难题,为高热流电子冷却提供可靠的 TEC 性能最大化方案。研究成果“Dual-embedded cooling for thermoelectric coolers in electronics thermal management”为题发表在《Applied Thermal Engineering》
03
图文导读
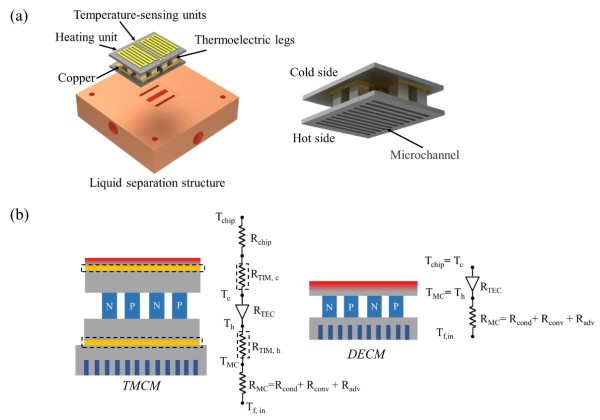
图1.(a)双嵌入式冷却模块的示意图。(b)双嵌入式冷却模块和TEC-MC冷却模块的热阻网络分解。
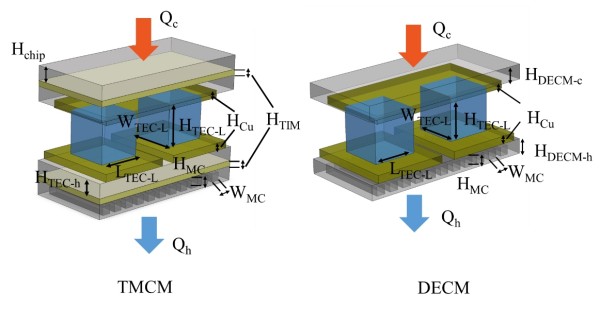
图2. TMCM和DEMC模型的示意图(显示一对热电腿)。
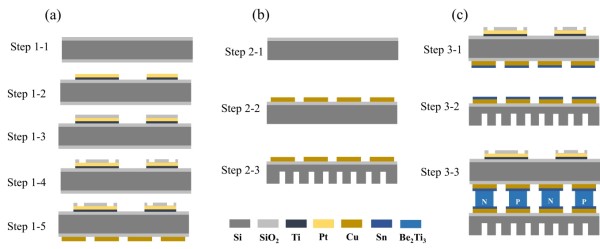
图3. 制造(a)冷侧和(b)热侧的工艺流程。(c)DMCM组件的示意图,将冷侧和热侧与热电腿集成。

图 4.试验平台示意图。
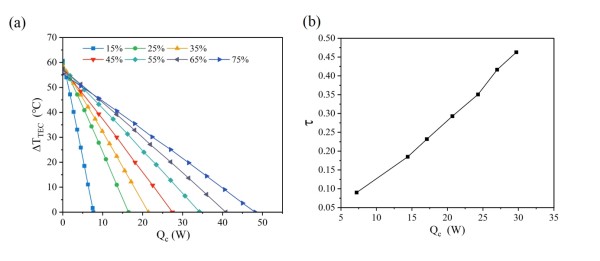
图 5.(a)不同填充率的冷却模块中冷热端温差随冷却功率的变化。(b)冷却功率对无量纲指数τ的影响。
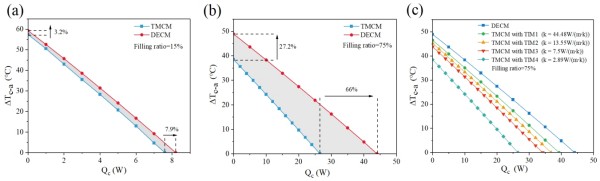


图7 .(a)在热端不同流速下,DECM中冷端温度的电流依赖性。(b)在TEC的最佳输入电流下,DECM中冷端温度随冷却功率的变化。(c)DECM和TMCM中电流依赖性芯片温度的比较(d)在最佳电流条件和100 mL/min的热端流速下,DECM和TMCM的芯片温度与功率的关系。
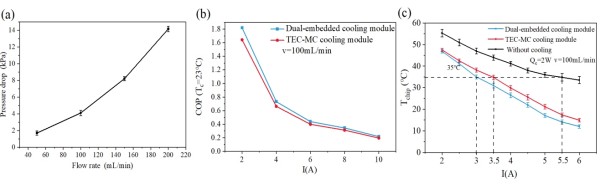


图9. (a)输入电流对模块总热阻的影响.(b)冷却功率对总热阻的影响.(c)总热阻的分解,无阴影柱代表DECM,对角阴影柱代表TMCM。所有实验均在100 mL/min的流速下进行。环境热阻评估DECM与四个先前关于传统芯片热管理方法的研究,这些方法将TEC与水冷却集成[27,34-36]。

