芯片热管理新突破,西工大嵌入式 TSV 微流控冷却方案
来源 | Applied Thermal Engineering
链接 | https://doi.org/10.1016/j.applthermaleng.2025.127699
01
背景介绍
在电子设备不断向 “更小、更密、更强” 进化的今天,三维集成电路(3D IC)技术凭借其能大幅提升芯片性能的优势,成为半导体领域的 “新宠”。它通过将芯片垂直堆叠,打破了传统二维布局的空间限制,让数据传输更快、功耗更低 —— 但这一突破性设计,也带来了一个棘手的 “副作用”:散热难。
随着集成密度越来越高,3D IC内部会形成局部热点,这些高温区域不仅会让芯片性能 “打折”,还会直接缩短其使用寿命。比如,当芯片运行高负载任务时,局部温度可能飙升至远超安全阈值,导致运算速度变慢、数据出错,甚至引发硬件损坏。
传统的散热方案早已 “力不从心”。美国国防高级研究计划局(DARPA)推进的 “ICECool” 项目,就将希望寄托在了微流控冷却技术上 —— 这种技术能让冷却液直接在芯片、基板和封装内部的热源点附近流动,精准 “带走” 热量,从根本上缓解热点问题,提升热分布均匀性。
与此同时,硅通孔(TSV)技术作为 3D IC 的核心互联方案,能大幅缩小互联尺寸、降低功耗,还能提升数据传输速度和信号完整性。但问题在于,将 TSV 结构嵌入 3D IC 后,热管理挑战变得更复杂了:层间高效散热、热应力缓解、界面可靠性保障,以及局部热流集中的管控,都是亟待解决的难题。如今一个关键方向逐渐清晰:将微流控冷却与 TSV 技术结合。这种融合不仅能兼容 TSV 的制造流程,还能实现 “近结冷却”(near-junction cooling),让散热效率和热稳定性再上一个台阶。但目前,能同时优化 TSV 阵列布局和微通道设计,兼顾散热性能与结构可靠性的集成方案还十分稀缺。
02
成果掠影

近日,西北工业大学微电子学院王少熙、汪钰成团队针对三维集成电路(3D IC)面临的高热流密度与局部热应力难题,构建了嵌入式硅通孔(TSV)结构的流固耦合微流控冷却模型。该团队通过计算流体动力学(CFD)模拟分析 TSV 阵列配置、微通道截面、流路拓扑及入口设计等对热性能的影响,发现采用波浪形与空腔型结合的变密度微通道布局,可在压降低于 20000 Pa 的同时实现约 15 K 降温;进一步用响应面法(RSM)和多目标遗传算法(MGA)优化空腔型微通道,获得 1.12 的性能增强系数(PEC),且模型对流热流密度达 1508.7 W/cm²、热阻 0.045 K/W;热应力分析表明,热源功率与 TSV 电流密度是应力集中主因,将 TSV 阵列远离热源并增大间距,可使 TSV 平均热应力降低约 50%、系统最大表面热应力降低约 32%,该研究建立的数值模型为 3D IC 微流控冷却优化提供量化基准,助力解决热挑战并提升系统可靠性。研究成果以“Study on microfluidic heat dissipation enhancement and thermal stress analysis in three-dimensional integrated circuit with through silicon via structures”为题发表在《Applied Thermal Engineering》。
03
图文导读

图 1:计算流体动力学(CFD)模拟流程图
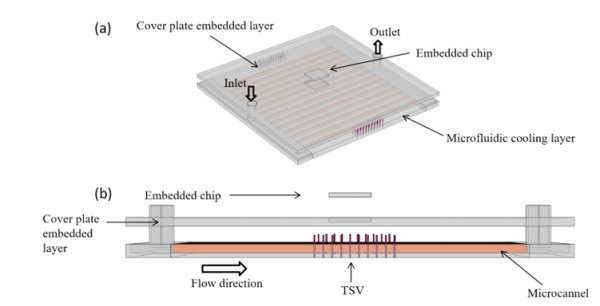
图 2:含硅通孔(TSV)的微通道散热模型示意图
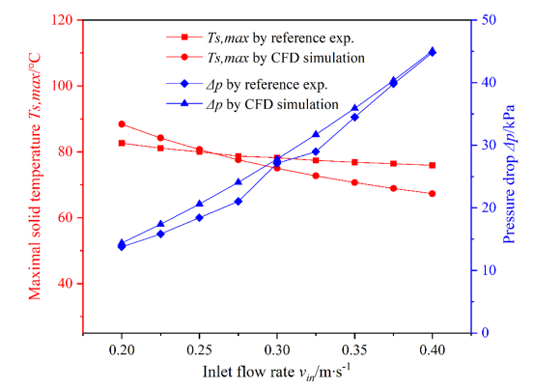
图 3:模拟结果与参考文献中实验数据的对比图

图 4:微通道散热结构的流动特性图(a)流体速度分布图(z-x 平面);(b)通道入口处压力分布图;(c)嵌入式 TSV 微通道散热结构内部流体速度分布图(x-y 平面);(d)中心微通道内流体速度流线图(z-x 平面)
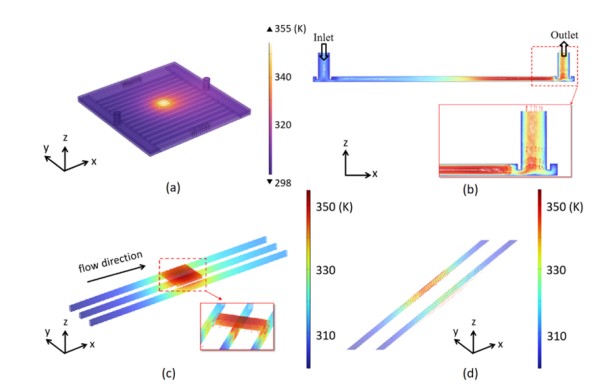
图 5:微通道传热特性图(a)嵌入式 TSV 微通道散热模块稳态温度等高线图;(b)微通道内流体中的对流传热图;(c)热源芯片与微通道之间的导热传热图;(d)相邻微通道壁之间的导热传热图
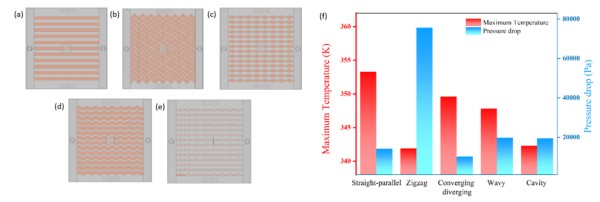
图 6:微通道结构与性能参数对比图(a)直平行微通道结构;(b)锯齿形微通道结构;(c)收敛 - 发散型微通道结构;(d)波浪形微通道结构;(e)空腔型微通道结构;(f)五种通道形状设计的性能参数结果
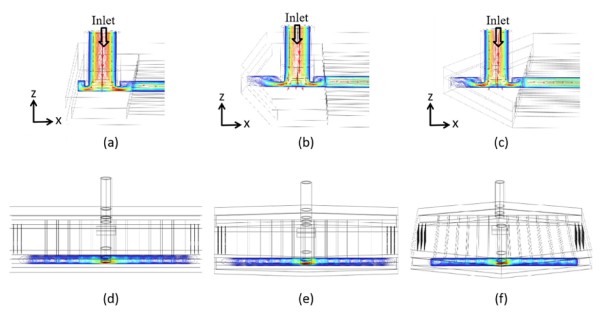
图 7:不同头部结构的入口流体速度与流线图(a)矩形头部入口处流体速度与流线;(b)对称梯形头部入口处流体速度与流线;(c)三角形头部入口处流体速度与流线;(d)矩形头部微通道入口处流体速度与流线;(e)对称梯形头部微通道入口处流体速度与流线;(f)三角形头部微通道入口处流体速度与流线
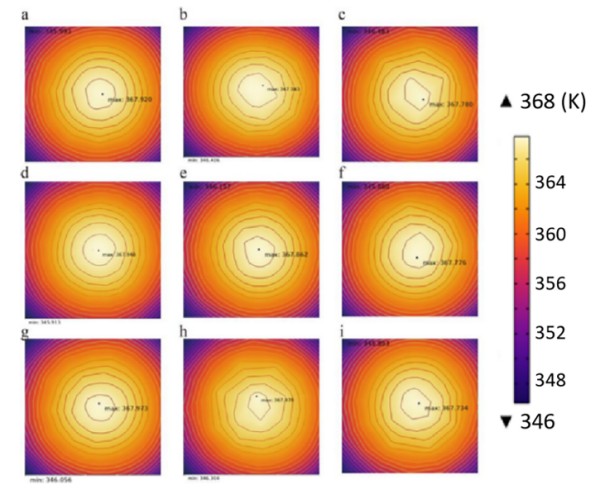
图 8:1 μm×1 μm×1 μm 热点在芯片表面随机分布时,热源芯片表面的热分布图与最高温度点
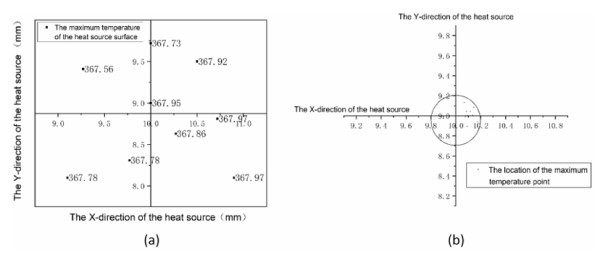
图 9:热点在热源芯片表面随机分布时的热分布图
(a)热点表面随机分布对应的热源表面最高温度二维散点图;(b)热点随机分布时热源表面最高温度点所在区域

图 10:散热效率优化示意图

图 11:回归方程预测结果图
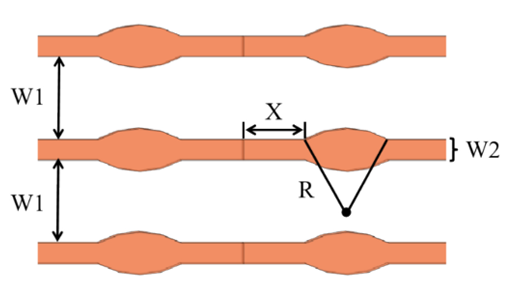
图 12:响应面分析四因素示意图

图 13:响应面分析结果图
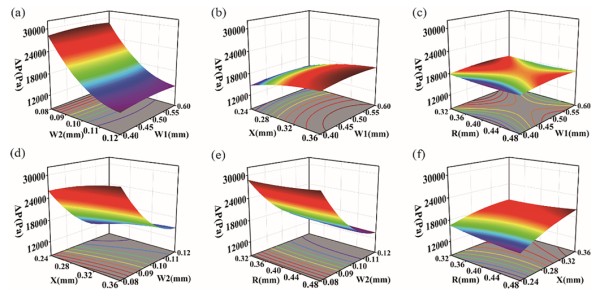
图 14:响应面分析结果图(压力降ΔP)

图 15:多变量遗传算法(MGA)优化解集结果图
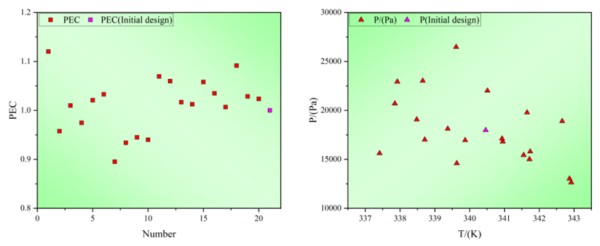
图 16:解集优化性能提升结果图
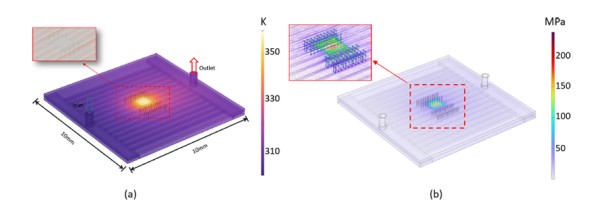
图 17:嵌入式 TSV 结构微流控冷却模型模拟结果示意图
(a)体积内温度分布图;(b)体积内冯・米塞斯应力分布图
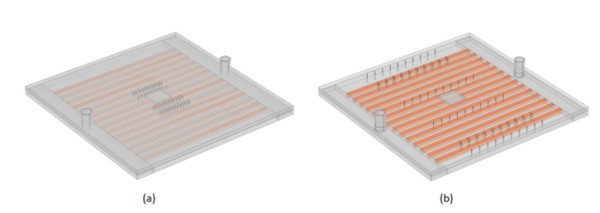
图 18:微通道散热模型中硅通孔(TSV)分布示意图(a)TSV 阵列位于热源附近;(b)TSV 阵列远离热源分布
