清华团队解决芯片散热难题,液态金属TIM热阻大降94%!
来源 | Advanced Materials Interfaces
链接 | https://doi.org/10.1002/admi.202500041
01
背景介绍
在电子封装领域,界面始终是制约传热效率的关键瓶颈,如何降低两种固体表面间的接触热阻,一直是该领域亟待解决的核心问题。目前,行业内常用的解决方案是在界面处涂覆导热硅脂,通过填充微观空隙来改善传热,但这种单纯的刷涂方式在热传递效率上远不及焊接工艺 。
随着晶体管尺寸不断微型化、封装密度持续提升,芯片的发热量已达到前所未有的水平。其中,氮化镓和氧化镓器件的热流密度甚至超过了 10 kW/cm²,传统直接刷涂导热材料的方式已无法应对如此巨大的热流。而焊接工艺虽能在一定程度上满足传热需求,却存在加工复杂、操作效率低的弊端,难以适配大规模、高效率的生产场景 。因此,研发一种兼具低接触热阻(Rc)与高加工效率的新型热界面材料(TIM),实现通过快速刷涂方式达到与焊料焊接相当的热性能,成为电子封装热管理领域的迫切需求与核心追求。
液态镓及其合金凭借固有的高导热性和良好的流动性,展现出作为高性能热界面材料的潜力,被视为解决上述问题的重要方向之一 。理论上,其特性使其有望实现超低接触热阻与高刷涂效率的双重目标。
近年来,研究发现通过化学工艺在液态金属与固体金属界面形成金属间化合物,可大幅改善二者的润湿性。据此推测,这种界面处理方式或许能同步改善界面传热效率,但目前尚无研究从微纳尺度理论分析与界面传热实验测量的角度,系统探究金属间化合物辅助下液态镓/固体金属的界面热特性,相关领域仍存在明显的研究空白。
02
成果掠影

近日,清华大学曹炳阳团队提出通过在液态镓与固态铜界面自合成金属间化合物来改善液态金属热界面材料(TIM)的热性能。第一作者中国科学院理化技术研究所张旭东研究员。该技术将界面热阻(Rb)从1.11×10⁻⁷ (m²·K)/W 降至6.94×10⁻⁹ (m²·K)/W(降幅达 94%),接触热阻(Rc)降低 90%;该提升源于界面传热载体从声子转变为电子、结合力从范德华力转变为金属键,在芯片应用中(热流密度 200 W/cm² 时),此方法实现的界面温差(10.2 °C)接近 InSn 焊料焊接(8.3 °C),远优于传统氧化法(30.1 °C),为解决电子封装高热流散热问题提供新方案。研究成果以“Improving the Thermal Performance of Liquid Metal Thermal Interface Materials: The Role of Intermetallic Compounds at the Gallium/Copper Interface”为题发表在《 Advanced Materials Interfaces》期刊。
03
图文导读

图1.通过自合成CuGa₂改善液态镓/铜异质界面的界面热传输。a) 化学处理过程;b) CuGa₂的SEM图像;c) 接触角;d) 润湿特性;e) 热边界阻力;f) 接触热阻;g) 微观传热机制。

图2.Rb的实验测试与理论分析。a) 样品A;b) 未处理样品A的测试流程;c) HCl处理样品A的测试流程;d) 样品B的结构与测试;e) 样品B的原始数据;f) 未处理样品A的原始数据;g) HCl处理样品A的原始数据;h) Ga/CuGa₂/Cu的理论热边界阻力;i) Ga/Ga₂O₃/Cu的理论热边界阻力;j) 实验与理论热边界阻力对比。

图3.Ga/Cu的界面润湿特性表征。a) 润湿力测试示意图;b) 铜棒的受力平衡;c) 润湿力;d) 模拟几何模型;e) 润湿与扩散过程;f) 原子分布;g) z = 3.05–3.25 nm区域的原子分布。
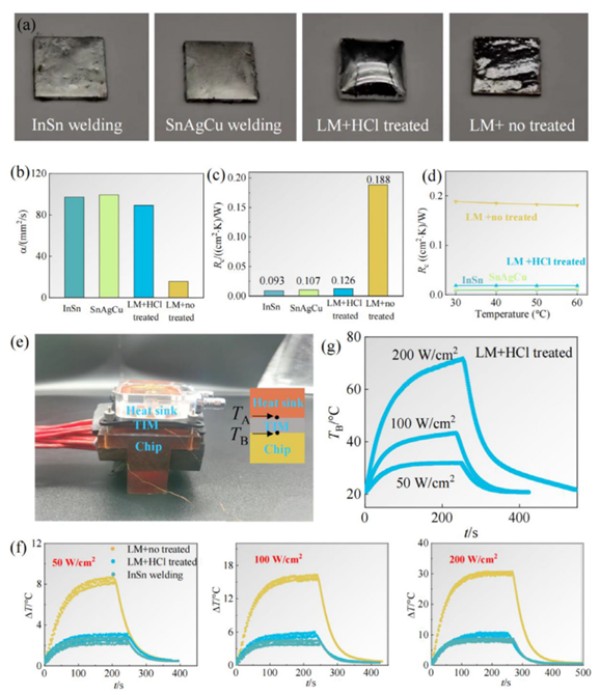
图4.不同TIMs的性能对比。a) 各样品形态;b) 热扩散系数;c) 接触热阻;d) 接触热阻随温度的变化;e) 被测模块;f) 温差ΔT随时间t的变化;g) 芯片温度TB随时间t的变化。
