一颗气泡的命运:芯片散热的“沸腾挑战”
随着电子信息技术的持续迭代,芯片正朝着高集成度、微型化与高性能化演进,单位体积内的发热功率持续攀升,当热量无法及时有效导出,芯片表面温度急剧升高,将带来性能退化甚至损伤风险。
风冷作为当前主流的散热方式,在当前热流密度面前渐显“力不从心”。液冷方案虽然具备更强的散热能力,但传统的强迫对流液冷仍受限于系统复杂度与热点适配难题。特别是在芯片不同区域功耗差异极大的情况下,局部热点成为“顽疾”,其热流密度甚至可超出平均水平一个数量级。单一的换热结构难以精准适配这些热点区域面临局部失控风险。
这也让浸没式相变液冷逐步走到台前——它通过让整个芯片裸露浸入冷却液中,以沸腾相变的方式将热量迅速带走,不再依赖接触面或中间换热结构。如图在理想状态下,其单位面积散热能力可超过100W/cm²,成为大功率芯片及数据中心系统的重要候选方案。
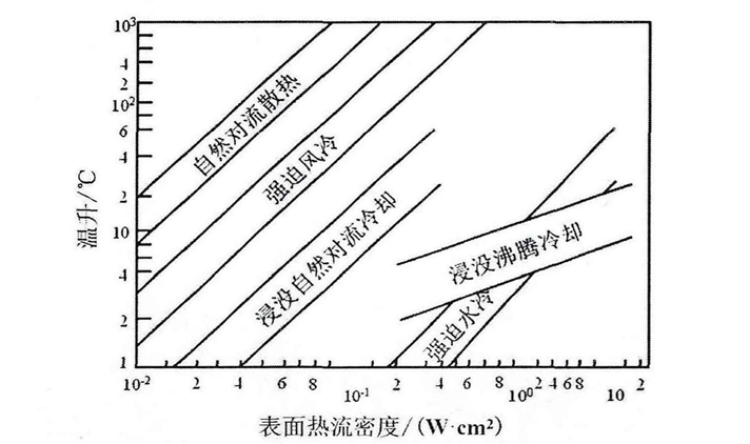
一颗气泡的诞生,看似平凡,却决定着浸没式液冷系统能否真正实现高效散热。在高热流密度芯片的时代,液冷的核心不止是“液体包围芯片”,而是——如何让气泡可控地“生”与“死”。

在浸没式液冷中,沸腾传热是最关键的散热机制之一。特别是在芯片局部功耗密度极高的场景下,冷却液能否快速汽化并有效带走潜热,决定了热设计成败。

但这不是简单的“泡泡越多越好”,沸腾过程主要包括两个阶段:
核态沸腾(Nucleate Boiling):气泡迅速生成、脱离、带走潜热,是高换热系数的理想状态;
膜态沸腾(Film Boiling):气泡融合成气膜附着在芯片表面,导致导热路径断裂、芯片“热烧”。
临界热流密度(Critical Heat Flux, CHF)是两个状态的分水岭。一旦芯片热流密度超过 CHF,系统将进入热失控边缘。
因此,液冷热设计的核心问题是:如何延迟 CHF,延长核态沸腾的稳定区间。这引出了两个重要设计策略:
表面工程:通过构建微纳结构(如铜柱阵列、亲疏水图案化等),可以人为引导气泡生成位置、尺寸与脱离频率,显著提升换热性能。
封装协同设计:芯片与载板的组合、TIM 材料、裸芯片封装等也直接影响热流分布和气泡行为。例如,局部热流密度突变可能诱发“气泡聚集”甚至提前进入膜态沸腾。
此外,冷却液的选择(饱和温度、热导率、表面张力等),也深刻影响着气泡的核化机制和脱离动力学。
在浸没式液冷系统中,热管理不止是在冷却液外部“做文章”,而是深入到芯片-界面-液体的多尺度耦合中。下一场液冷突破,或许就隐藏在一颗气泡的轨迹里。
为深入探讨液冷在数据中心、AI服务器、储能系统与新能源汽车等关键场景的创新应用路径,由DT新材料主办的“2025液冷产业创新与应用论坛”将于今年盛大举行。论坛汇聚产业链核心企业、头部应用方与科研机构,共话液冷技术从材料—系统—标准—应用的全链条协同创新。
本届“液冷产业创新与应用论坛”汇聚了高校、材料、组件及服务器企业的技术专家等重磅嘉宾,围绕冷板、浸没、CDU、AI控制、芯片级散热、TIM等话题展开技术交流与趋势研判。

现在扫描上方二维码就可加入这场液冷科技盛会
与行业同仁分享您的见解、展示您的创新
