一种基于Al₂O₃-BN填料的高导热复合材料,具备规模化潜力!
来源 | Ceramics International
链接 | https://doi.org/10.1016/j.ceramint.2025.04.027
01
背景介绍
在微电子设备的热管理中,急需同时具备高导热性和优异电绝缘性的热界面材料(TIMs)。为了实现高导热性通常需要极高的填料负载量,这会损害复合材料的其他性能,如柔软性和流动性。目前为止,人们已经利用多种技术来促进基体内部有序导热路径的构建,从而减少内部缺陷的发生,以减轻声子散射。但是,这些方法通常难以实现进一步的工业规模化生产。目前,商业上可获得的绝缘TIMs主要是通过填充球形氧化铝(Al₂O₃)到硅橡胶中制成的,因为其成本低且性能高。然而,尽管已经具有极高的负载比例,所合成的聚合物复合材料通常仍表现出较低的热导率。因此,迫切需要开发在充分考虑填料负载量、形态、聚合物基体的加工性能以及规模化生产能力的情况下,具有高导热性的聚合物复合材料。在各种填料中,六方氮化硼(h-BN)具有类似于石墨烯的层状结构,表现出高热导率、优异的电绝缘特性和化学稳定性,因此被认为是制造具有高热导率和电绝缘性的柔性TIMs的有希望的候选材料。
02
成果掠影

近日,吉林大学殷红、高伟团队通过传统热压法,基于氧化铝和氮化硼二元填料,制备出具有规模化生产潜力的高导热性聚合物复合材料。不同粒径和形状的Al₂O₃和BN被功能化作为二元填料。通过利用基于Dinger-Funk颗粒堆积理论的多种分级方案,球形Al₂O₃复合材料实现了5.12 W/mK的导热率,并达到了最大堆积密度。进一步与BN混合后,得到的柔性薄膜具有显著的导热率,为9.23W/mK,约为纯硅橡胶的50倍。同时,合成的复合材料表现出电绝缘性、柔韧性、可压缩性,以及即使在从室温到120°C的循环温度冲击后也具有显著的稳定性,这些特性有利于工业应用的环境适应性。这项工作提供了一种可行的策略,用于合成基于BN的TIMs,并为它们的大规模实际应用铺平了道路,以实现有效的热管理。研究成果以“Highly thermal conductivity flexible composite films based on alumina-boron nitride binary fillers”为题发表在《Ceramics International》期刊。
03
图文导读

图1.无机填料的扫描电子显微镜(SEM)图像。(a)原始六方氮化硼(h-BN),(b)改性后的h-BN;(c)原始球形氮化硼(S-BN),(d)改性后的S-BN;(e)原始氧化铝(S-Al₂O₃),(f)改性后的S-Al₂O₃。

图2.填料的表面改性和分散性。(a)原始和改性BN的傅里叶变换红外光谱(FT-IR)和(b)XRD图谱。(c)原始、羟基化和改性S-BN的FT-IR光谱和(d)XRD图谱。(e)原始和改性S-Al₂O₃的FT-IR光谱和(f)XRD图谱。(g)原始和改性BN在硅油中分散0天、7天、14天和30天的分散性。
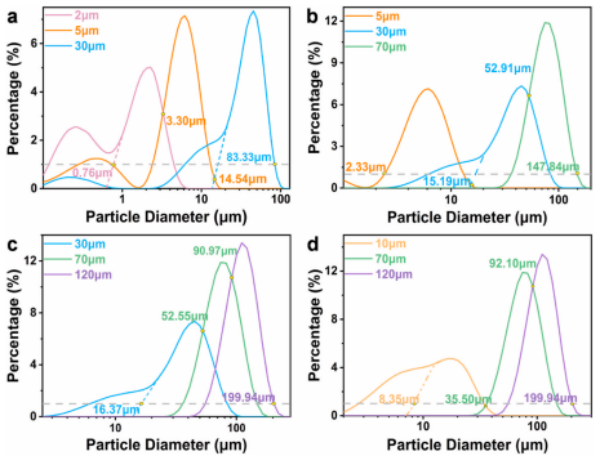
图3.不同尺寸组合的Al₂O₃颗粒的分布分析。(a)A1组合:2 μm、5 μm、30 μm;(b)A2组合:5 μm、30 μm、70 μm;(c)A3组合:30 μm、70 μm、120 μm;(d)A4组合:10 μm、70 μm、120 μm。

图4.不同分级方案下,负载量为90wt%的S-Al₂O₃/SiR复合材料。(a-d)固化前A1、A2、A3、A4复合材料的流动性。(e)固化后复合材料的导热系数,以及(f-i)复合材料的SEM图像。

图5.热界面材料的整体性能。(a)含有不同填料的硅橡胶(SiR)复合材料的肖氏硬度和导热系数。(b-d)S-BN/SiR复合材料、S-BN/BN/SiR复合材料、S-Al₂O₃/BN/SiR复合材料的SEM图像。(e)大规模S-Al₂O₃/BN/SiR块状材料的光学图像。(f)基于S-Al₂O₃/BN/SiR的可控形状的热导垫的光学图像。(g)块状热导垫的弯曲和恢复,厚度约为200 μm。(h)机械和导热性能。(i)S-BN/SiR(绿线)和S-Al₂O₃/BN/SiR(蓝线)的热、电和机械性能。
图6.S-Al₂O₃/BN/SiR复合材料的热界面应用演示。(a)导热垫在循环加热过程中热导率的稳定性图。(b)热导率随加热温度的变化。(c)热导垫热界面应用示意图。(d)固化热导垫上的LED芯片照片。(e)LED在没有热管理、固化热导垫和未固化热导膏下的热红外记录图像。(f)LED芯片表面记录的温度变化。(g)大批量导热垫图片。
